全面膜厚測定ユニット
ESTM:Entire Surface Thickness Measurement Unit
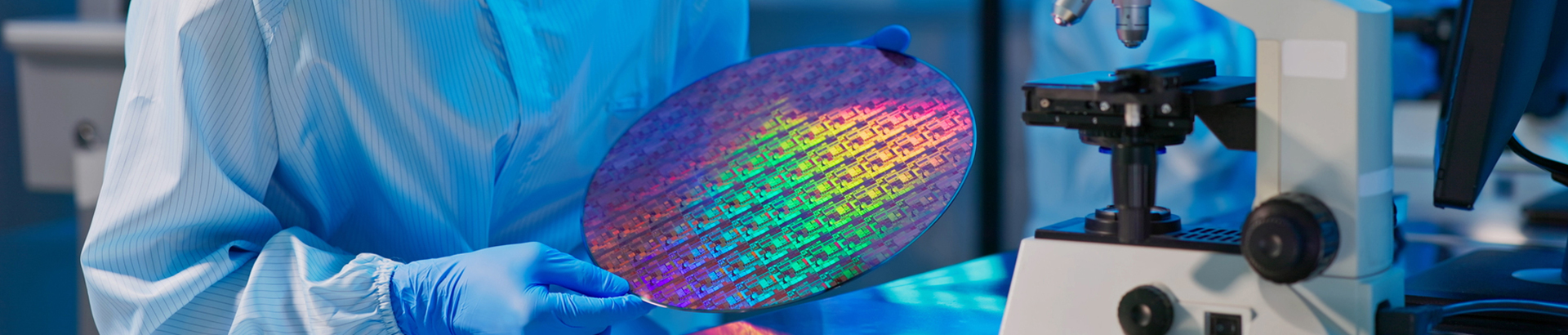
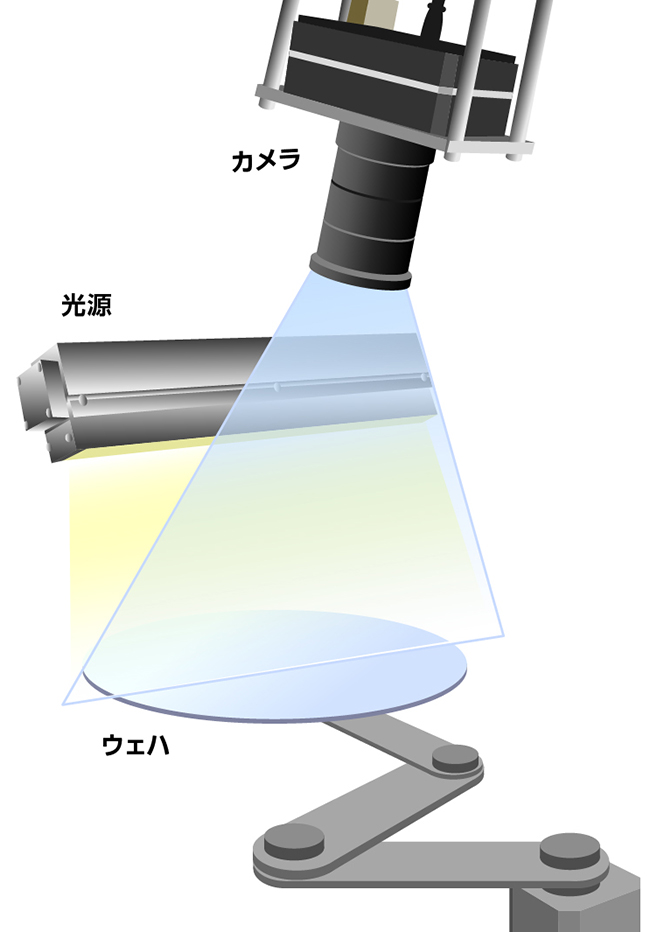
全面膜厚測定ユニットとは
カメラと光源を用いて、シリコンウェハなどの上に成膜されたシリコン酸化膜(SiO2)やレジストなどの膜厚を全面測定する装置です。
組み込み可能なユニットタイプ。EFEM内などに設置でき、半導体製造装置内でIn-situかつ全数の膜厚測定を実現します。
また、ウェハ全面の膜厚を300,000 point/sec.で高速測定するため、膜厚の詳細なモニタリングやそれを用いたプロセスフィードバック、局所的な膜厚異常の検出も可能です。
LINE UP
機種一覧
全面膜厚測定ユニット ESTM:Entire Surface Thickness Measurement Unit
主な業界
半導体、シリコンウェハ製造、レジスト塗布、各種成膜
半導体業界向け。ウェハ全面を300,000 point/sec.で測定可能。製造装置に組み込み可能なユニットタイプでIn-situの製造プロセスモニタリングを実現。
FEATURE
特徴
装置構成:In-situ測定が可能なユニットタイプ
測定部はカメラと光源のシンプルな構成。測定部の下をウェハが通過するだけで全面測定が可能です。EFEM内などに設置することで、In-situ膜厚のモニタリングが可能になります。
300,000 point/sec.の高速全面測定
ロールtoロールのインライン検査で培った高速処理技術で、300,000 point/sec.の高速測定を実現しました。これまで不可能とされていた「全数」「全面」測定を実現しました。
ナノオーダーの薄膜測定が可能
「全面膜厚測定ユニット」は、最小20nmの薄膜まで測定が可能です。日々、薄膜化が進む半導体製造プロセスに対応します。
膜厚異常部分の検出機能を搭載
取得した膜厚データから異常部分を自動で検出します。膜厚の異常を検出した位置や個数を把握することによって、検出機能だけでなく工程管理に役立てることが可能です。
環境への影響が少ない低パーティクル構造
駆動部を持たない構成によって、半導体製造装置内のクリーン度に影響を与えません。
MERIT
導⼊のメリット
全面膜厚測定ユニットの導入によって、以下の6つが実現可能になります。
| 01In-situ膜厚測定によって リアルタイムで成膜をモニタリング |
02抜き取り測定では困難だった 全面・全数測定 |
| 03膜厚測定にかかる工数の削減 | 04ロット単位ではなく ウェハ単位で不良品を検出 |
| 05製造装置の詳細な状態監視による 精密なフィードバック |
06現行装置に後付けできるユニットタイプによる フットプリントを抑えた膜厚測定 |
FLOW
導⼊のフロー

納
品
ま
で
丁
寧
に
サ
ポ
|
ト
- STEP.1
- お問い合わせ
- STEP.2
- 要求仕様および運用のヒアリング
- STEP.3
- 厚さ測定対象のサンプルテスト
- STEP.4
- 仕様提案
- STEP.5
- 仕様の最終打ち合わせ
- STEP.6
- ご発注
- STEP.7
- 生産
- STEP.8
- 出荷前の立会検査
- STEP.9
- 納品・現地調整
